개요
반도체 패키징 개요
반도체 소자의 단순 미세화(scaling)에 따른 성능 발전 방식 한계에 봉착함에 따라, 저전력・고성능 구동 조건을 충족하는 고집적 소자 구현을 위한 패러다임 변화 요구
- 현재의 반도체 미세화 방식이 갖는 설계 기술 및 제조 공정의 고비용・고난이도에 따른 경제적 효율성 저하를 극복하기 위한 돌파구 마련 필요
- 단순히 소자의 성능・가격을 개선하기 위한 미세화 공정 중심의 반도체 개발 방향은 시장 수요에 맞춰 시스템과 응용 분야 중심으로 전환 중


 반도체 산업이 자동차, 에너지, 의료, 환경 등 전(全)산업 분야로 확산하며, 다기능 반도체에 대한 수요 증가
반도체 산업이 자동차, 에너지, 의료, 환경 등 전(全)산업 분야로 확산하며, 다기능 반도체에 대한 수요 증가
- 사용자와의 소통이 필요한 대부분 전자기기는 다기능을 갖춘 반도체가 요구되며, 이를 구현하기 위해 개별 소자들의 단일 패키지화가 요구
- 또한, 시장 수요를 충족하는 다기능화 소자 구현과 함께 가격경쟁력까지 갖추기 위한 반도체 제조 공정의 고도화가 필요
- 패키징 공정은 전공정에서 제작된 집적회로소자를 포장하여 완성품으로 제작하는 과정으로, 향후 반도체 소자의 고집적・다기능 구현을 위한 핵심 기술로 주목
- 첨단 패키징(Advanced package) 기술의 도입으로 다양한 칩을 하나의 소자로 통합이 가능해 지며, 전기적 연결과 반도체 소자의 보호가 목적이었던 전통적인 패키징 기술을 대체하며 고부가가치를 구현하는 산업 내 핵심경쟁력으로 부상
반도체 패키징 역사
1965년 최초의 반도체 패키지가 발명된 이후 반도체 패키징 기술은 비약적으로 발전했으며 수천 가지의 다양한 반도체 패키지 유형이 만들어졌다. 아래 차트는 반도체 패키징의 역사를 보여준다.
특히 반도체 패키징의 두 가지 주요 추세인 높은 핀 수 해결과 작은 풋프린트 요구 사항 수용을 보여준다.
오늘날 대부분의 반도체 장치는 다이와 연결 와이어의 손상을 방지하기 위해 패키지로 둘러싸여 있다. 그러나 ASIC 엔지니어나 구매 관리자에게 묻는다면 반도체 패키징은 실리콘 다이에 바람직하지 않은
추가 요소이다. 총 칩 면적이 증가하고 총 비용이 증가하며 실리콘 다이의 전기적 성능이 감소한다. 그러나 반도체 패키징에는 상당한 이점도 있다.
반도체 패키지는 실리콘 다이와 PCB 사이의 전기적 연결을 가능하게 한다. 이 패키지는 고밀도 다이 패드를 더 넓은 영역으로 확장하여 PCB 레이아웃 및 어셈블리를 쉽게 만들 수 있도록 도와준다.
전력 소모가 많은 애플리케이션에서 반도체 패키지의 책임은 실리콘 다이에서 생성된 열을 방열판과 같은 넓은 표면으로 분산키는 것이다. 이를 통해 다이는 고온 환경에서 정상적으로 계속 작동할 수 있다.



반도체 패키징 구조
반도체 패키지의 구조는 반도체 칩, 칩이 올려지는 캐리어(패키지 PCB, 리드 프레임 등), 그리고 이를 둘러싸는 몰딩 컴파운드로 구성된다. 또한 내부 및 외부 연결 경로는 내부 칩에서 외부로
신호를 연결하는 역할을 한다. 내부 연결이든 외부 연결이든 이 연결은 이전에 라인(와이어 또는 리드 프레임)으로 이루어졌다. 그러나 최근에는 포인트(범퍼 또는 볼)를 주로 사용하고 있다.
한편, 몰딩 컴파운드는 내부의 열을 빼내고 외부 손상으로부터 칩을 보호하는 중요한 역할을 한다.
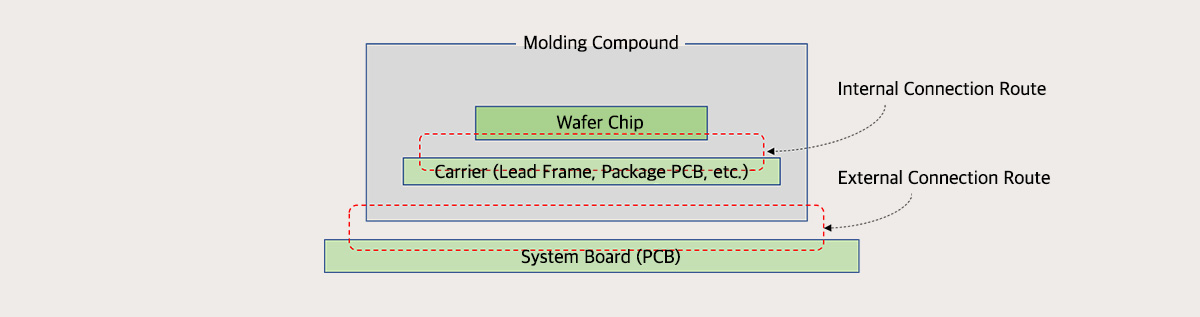
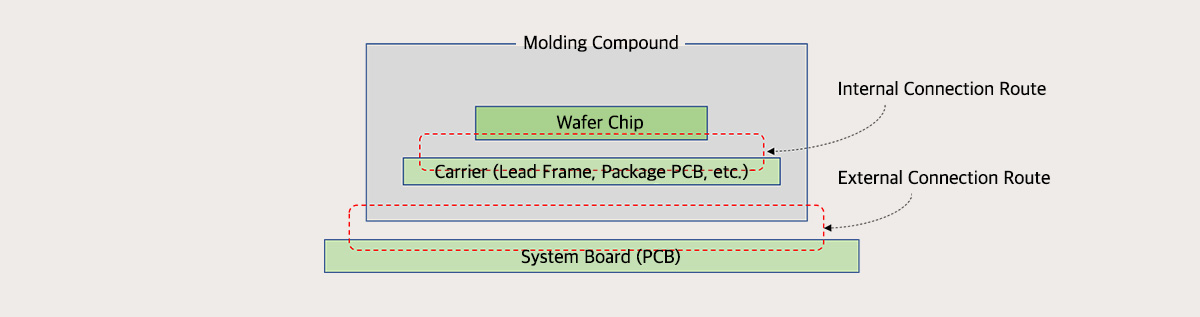
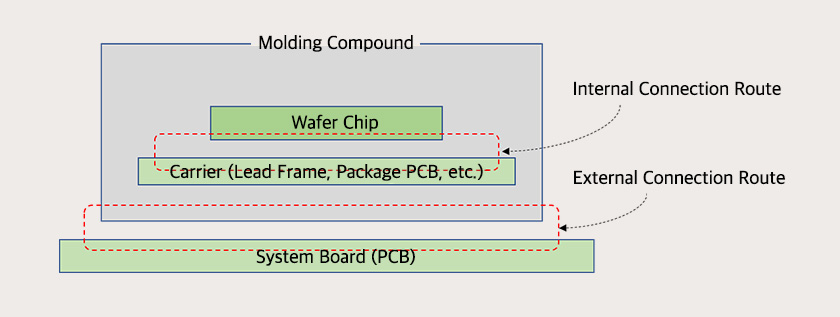
반도체 패키징 분류
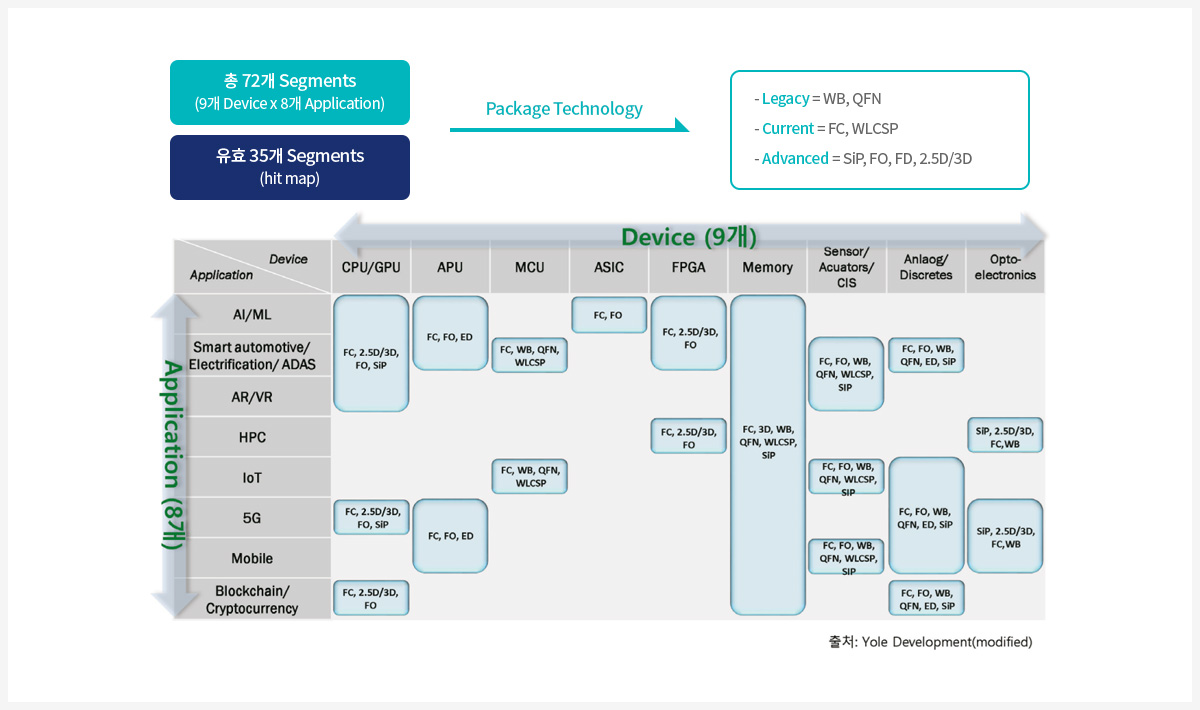
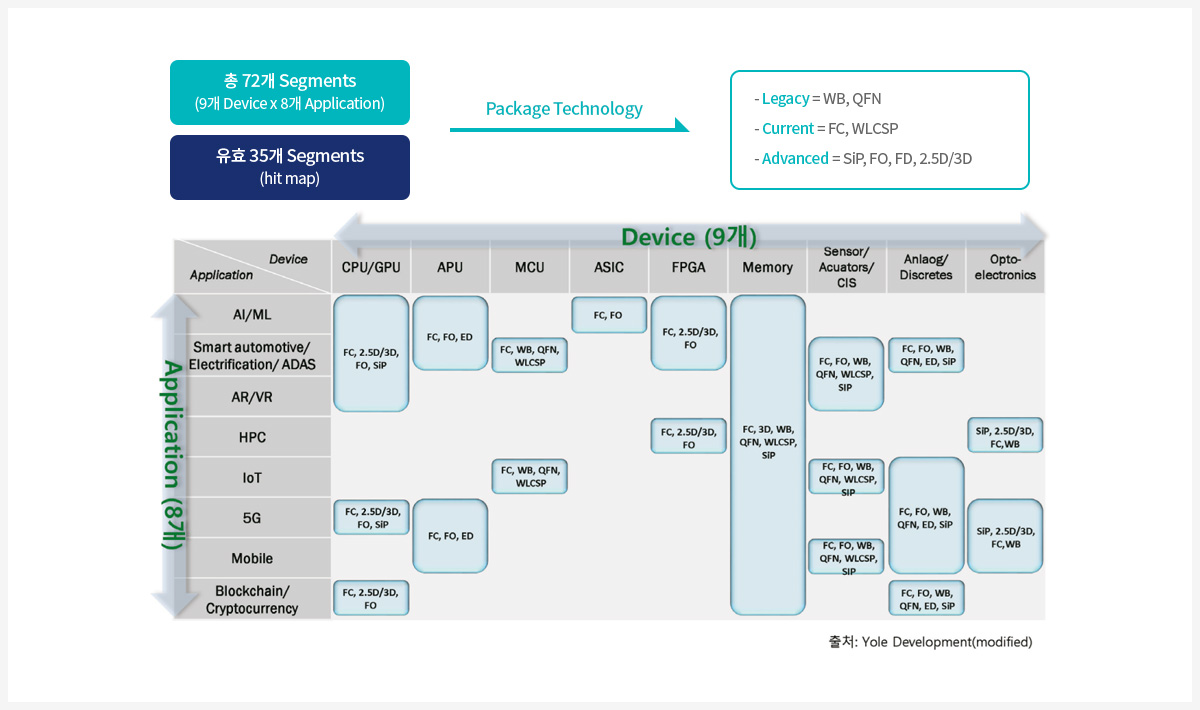
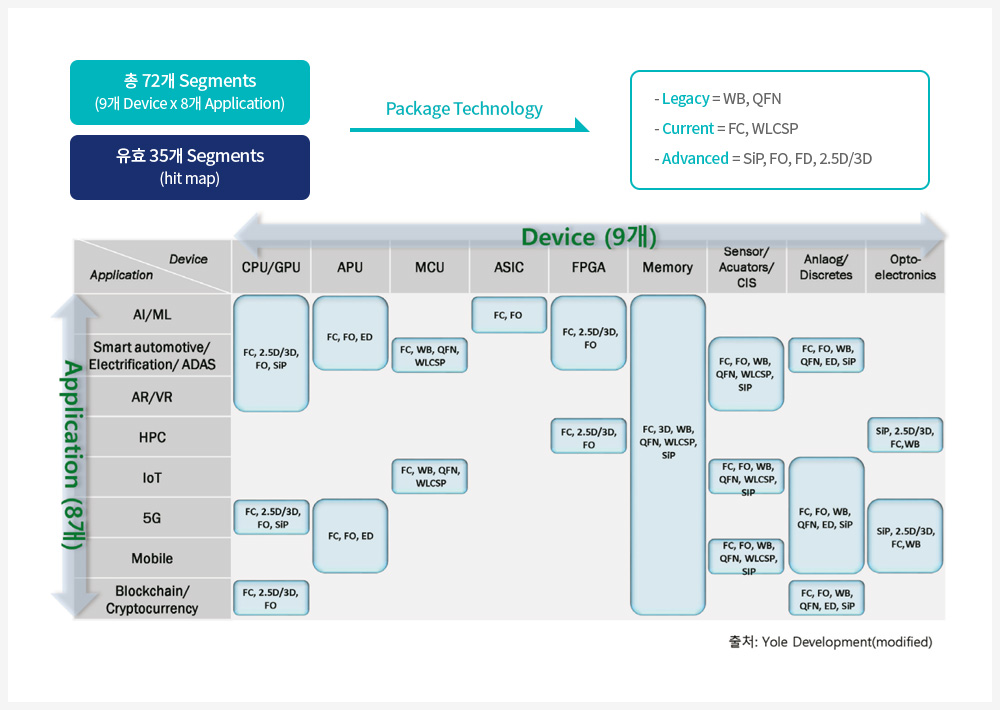
출처
- KISTEP 한국과학기술기획평가원 기술동향브리프 2020-16호 반도체 후공정(패키징) https://anysilicon.com/semiconductor-packaging-history-trends/
- https://news.skhynix.com/light-thin-short-and-small-the-development-of-semiconductor-packages/
- Heterogeneous Integration Roadmap, 2021 Edition (http://eps.ieee.org)
- John H Lau, Unimicron Technology Corporation, Recent Advances and Trends in Advanced Packaging, IEEE EPS Binghamton Chapter, April 13, 2022
